除了更少的光子暴露在光刻胶上之外 , EUV 光刻胶也吸收更少的光子 。 这主要因为光刻胶溶液是光酸产生剂、粘合促进剂和稳定剂的极其精确的混合物 。 那就意味着如果在过程中出现差错 , 会是一个代价高昂的错误 。 2019 年 , 台积电的 Fab 14B 光刻胶出现问题 , 最终给他们带来高达5.5 亿美元的损失 。 使用 EUV 光刻胶 , 这种平衡行为更加难以控制 , 因为特定的混合物会导致吸收更少 。 对 EUV 的需求以及 1-2 次更少光子和更少吸收的需求相结合 , 为经典光刻胶行业提供了一个成熟的机会 。 这就吸引厂商进入干燥抗蚀剂(dry resist)市场 。
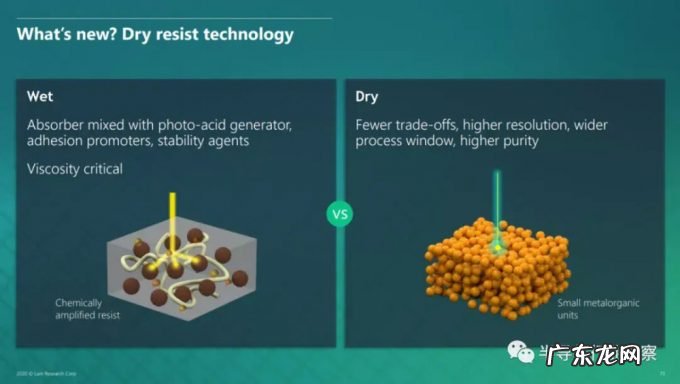
文章插图
Lam Research 正试图成为当中的搅局者 。 他们将使用化学气相沉积工艺在金属光刻胶上分层 , 而不是使用旋涂机的湿式光刻胶(wet photoresist )技术 。 Lam Research声称干式光刻胶技术(dryresist )与湿式光刻胶相比具有多项优势 。 由于是一种密集沉积的金属(metal) , 它不会与许多其他化学物质混合 。 这允许金属光刻胶仅作为吸收剂 。 回到吞吐量 , 这意味着每个晶圆通过和功率降低了 2 倍 。 每台 EUV 工具吞吐量几乎翻倍 , 这将大大降低成本 。

文章插图
灵敏度并不是唯一的优势 。 Lam 的干式光刻胶也是采用干法开发的 。 在湿显影中 , 光刻胶用水或酸洗涤 。 当光刻胶由于毛细作用力溶解掉时 , 图案化的线条和其他特征可能会坍塌 。 随着最小金属间距 (MMP) 超过 28 纳米 , 这越来越成为一个问题 。 台积电的 N5 和 N4 工艺节点的 MMP 分别为 30nm 和 28nm , 因此当前的出货节点正好处于边缘 。
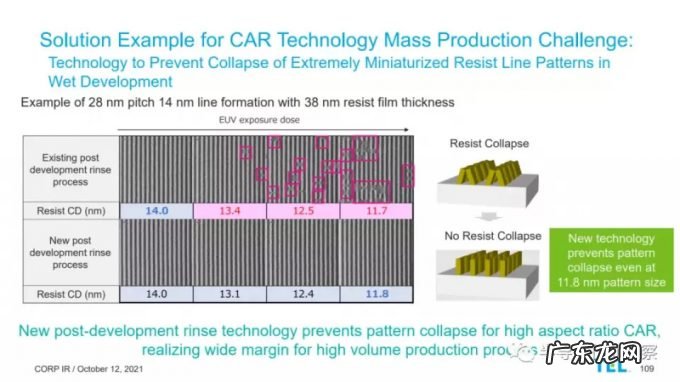
文章插图
然而 , 东京电子仍有创新在进行中 。 虽然他们同意现有的开发冲洗工艺确实会导致超过 28nm 间距(14nm 临界尺寸)的生产线塌陷 , 但他们发现了一种新的溶剂冲洗工艺 , 可以将其扩展到 ~24nm(12nm 临界尺寸) 。 这将允许将湿抗蚀剂方法缩放到 24 纳米 。
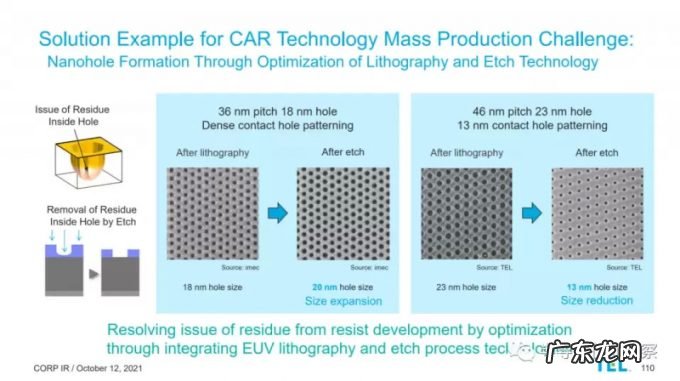
文章插图
但并不是湿抗蚀剂的所有问题都解决了 , 因为我们还是很难洗掉所有的光刻胶 。 如果所有的光刻胶没有被洗掉 , 以后的步骤就会有问题 。 残留的光刻胶在蚀刻时会导致孔洞 , 最终相互“亲吻” 。 残留物也可能导致这些孔完全丢失 。
东京电子目前对此的解决方案是简单地蚀刻残留的光刻胶 。 虽然这是一个简单的解决方案 , 但可能会出现复杂情况 , 因为它会导致孔变大或倾斜 。 斜面效果不一定是负面的 , 但也不是在所有用例中都是最佳的 。

文章插图
Lam Research 声称他们的工艺可以实现 5nm 节点上使用的现有 32nm 间距 , 与现有的湿式光刻胶工艺相比 , 其方案具有更低的可变性和更好的宽容度 。 我们无法与 Lam Research 分享的硬性数字进行争论 。 当晶圆厂追求特征尺寸、性能和功耗时 , 干法工艺总体上更好 。 由于显示了当前部署的工具和流程与即将推出的工具和流程 , 因此 Lam Research 进行的比较可能被认为是不诚实的 。

文章插图
与此同时 , 东京电子正在尽最大努力延长现有产品的寿命 。 他们的Clean Track Lithius Pro Z 与每台 ASML EUV 机器一起使用 。 事实证明 , 它对于最初的 EUV 节点是可靠且高效的 , 但随着行业超越单一图案化 EUV , 化学放大抗蚀剂 (CAR) 显然已达到极限 。 在其他条件相同的情况下 , 干式抗蚀剂将在前沿和最小特征尺寸方面获胜 。
- 北京三批集中供地来了,头号热门劲松地块全现房销售 | 楼市
- “霸道总裁”马斯克:我的指示只允许三种回应 做不到请辞职
- 每日优鲜三季度亏损近10亿,上市后股价下跌超六成
- 又一科技巨头为“元宇宙”站台!英伟达CEO:它将比物理世界大得多
- 困扰热力学的三个妖精
- 三季报亏92.15亿,还有1412亿债务压顶!苏宁何时才能摆脱困境?
- 三星推出3纳米芯片制造工艺工具与技术
- 倒三角的身材是训练肩部吗?
- 脑洞大开:如果雷霆三少从未分开,联盟会是什么样子?
- 小米连续两周紧追苹果,销量排名第二,力争三年后全球第一!
特别声明:本站内容均来自网友提供或互联网,仅供参考,请勿用于商业和其他非法用途。如果侵犯了您的权益请与我们联系,我们将在24小时内删除。
