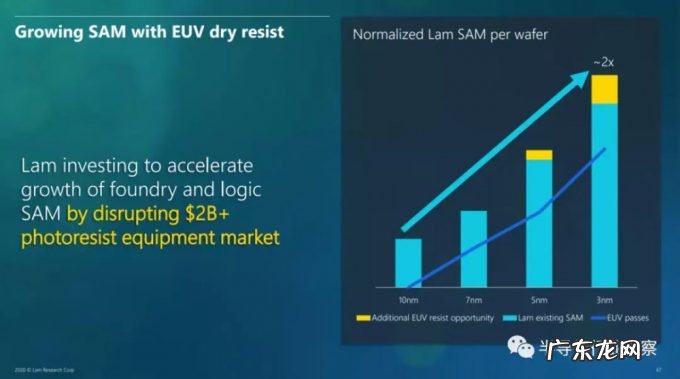
文章插图
Lam Research 最初的目标是在 5nm IMEC 节点(代工厂为 3nm)上使用 。 他们与 IMEC 和ASML 合作进一步开发这项技术 。 Lam 还与三星、英特尔、台积电和 SKHynix 合作 , 将该技术用于逻辑节点和 DRAM 节点的商业化 。 这显然很有希望 。
面对汹涌袭来的新挑战者 , 东京电子和光刻胶老牌企业并没有坐以待毙 , Inpria就是其中的代表 。 他们开发了一种新型光刻胶 , 金属氧化物抗蚀剂 (MOR) 。
Inpria 于 2007 年诞生于俄勒冈州立大学研究中心 。 此后 , Inpria 获得了来自三星、英特尔、应用材料、台积电、SKHynix、JSR 和 TOK 的大量投资 。

文章插图
Inpria 的投资者是该行业的巨头 。 它包括与 Lam Research 合作将干式抗蚀剂商业化的所有 4 家公司 。 该名单还包括前面提到的 CAR 光刻胶的领导者JSR 和TOK 。 JSR 在 2017 年和 2020 年参与了 Inpria 的几轮融资 , 最近他们硬着头皮以 5.14 亿美元直接收购了该公司——对该公司的估值为 7.42 亿美元 。 对于一家以预收入为基础开发化学品的工业公司来说 , 这是一个令人印象深刻的估值 。
很明显 , 该公司拥有价值不菲的知识产权 。 JSR 管理往往非常保守 , 因此它充分说明了正在发生的中断 。 光刻胶行业与 TokyoElectron 合作了数十年 , 而 JSR/Inpria 正在继续这种紧密结合的伙伴关系 。 他们正在共同开发光刻胶、工艺和涂布机/显影剂 , 以为下一个即将实现商业化工艺节点做好准备 。
MOR 仍然使用与当前光刻工艺类似的步骤 。 通过悬浮在溶液中 , 将其旋涂到硅片上 。 他们可以通过升级 , 从而可以在相同的Tokyo Electron Clean Track Lithius Pro Z上使用 。 这种升级不是资本密集型的 , 且可以使用 CAR 或 MOR 光刻胶 。

文章插图
MOR 仍然是湿的 , 这意味着某些问题仍将存在 , 即沉积的选择性 。 晶圆上光刻胶的潜在不均匀沉积会导致曝光和烘烤工艺步骤出现问题 。
Lam Research 干式抗蚀剂技术的最大优势之一是使用化学气相沉积 (CVD) 工艺来沉积光刻胶 , 从而可以更精细地控制光刻胶的可变性和厚度 。
众所周知 , 获得合适的厚度对于光刻胶来说非常重要 。 如果有极薄的层 , 则光刻工具具有更高的性能和吞吐量 , 因为需要曝光的光刻胶更少 。 另一方面 , 蚀刻时会损坏薄抗蚀剂膜(负光致抗蚀剂) 。 厚的光刻胶层不仅会导致较低的吞吐量 , 还会导致图案塌陷和显影后残留的光刻胶留在孔中 。
TokyoElectron 和 JSR 声称他们有一种新的金属氧化物抗蚀剂曝光后烘烤工艺 , 这将有助于提高光刻胶的灵敏度 。 这意味着晶圆厂可以显著降低 EUV 机器所需的剂量 , 从而提高产量 。
TokyoElectron 声称用量减少了 38% , 而 Lam Research 声称干式抗蚀剂用量减少了 50% 。 Tokyo Electron 还声称新的曝光后烘烤可实现极其均匀的抗蚀剂厚度和低金属污染 。 如果这些说法成立 , 那么这可以延长湿光刻胶的使用寿命 。
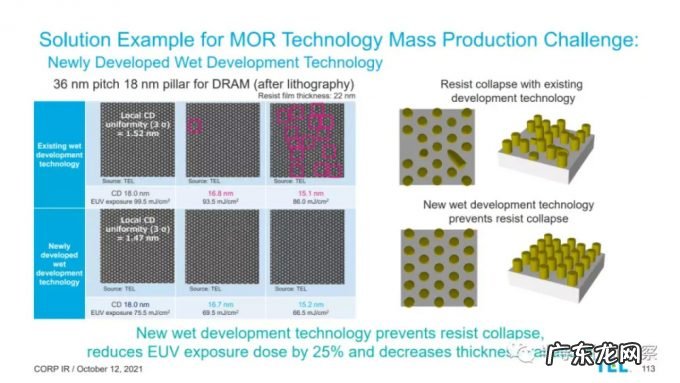
文章插图
同样 , Tokyo Electron 和 JSR 拥有新的湿法开发工艺 , 可以抵抗支柱倒塌(pillar collapse )问题 。 36nm 支柱经常崩塌 , 这是 DRAM 中电容器缩放的最大挑战之一 。 新的显影工艺也适用于较低的 EUV 剂量 , 并减少了最终特征的厚度变化 。

- 北京三批集中供地来了,头号热门劲松地块全现房销售 | 楼市
- “霸道总裁”马斯克:我的指示只允许三种回应 做不到请辞职
- 每日优鲜三季度亏损近10亿,上市后股价下跌超六成
- 又一科技巨头为“元宇宙”站台!英伟达CEO:它将比物理世界大得多
- 困扰热力学的三个妖精
- 三季报亏92.15亿,还有1412亿债务压顶!苏宁何时才能摆脱困境?
- 三星推出3纳米芯片制造工艺工具与技术
- 倒三角的身材是训练肩部吗?
- 脑洞大开:如果雷霆三少从未分开,联盟会是什么样子?
- 小米连续两周紧追苹果,销量排名第二,力争三年后全球第一!
特别声明:本站内容均来自网友提供或互联网,仅供参考,请勿用于商业和其他非法用途。如果侵犯了您的权益请与我们联系,我们将在24小时内删除。
